良率之战:晶圆检测的宏观缺陷检测
在半导体制造中,产量与吞吐量直接影响芯片成本。为确保良率,厂商需在各关键工序部署在线检测系统,实现从晶圆到封装的全程监控,以检测缺陷。早期缺陷检测可优化工艺、提升产量并降低成本。随着器件尺寸不断微缩,检测系统面临更高要求——需识别微米级/亚米级缺陷。宏观缺陷检测尤为关键,因为任何微小缺陷(包括晶圆背面污染)都将严重影响生产质量与最终良率。

图一:芯片截图示例
半导体制造是一个以纳米为单位的精密世界,但决定成本的往往是微米级的缺陷。在工艺稳定的情况下,缺陷逃逸率每降低1%,就可能避免数百万美元的损失。在线检测系统旨在100%检测出晶圆上的产量限制缺陷。因此,检测系统的周期时间对于晶圆厂的总体产量至关重要,因而成为高端检测系统设计的关键要素。
缺陷分类
在晶圆制造中,缺陷大致分为两大类:
① 微观缺陷< 1μm
② 宏观缺陷 > 1μm
在稳定的工艺中,缺陷逃逸率每降低1%,就可能避免数百万美元的损失。宏观缺陷检测(>1μm)之所以关键,是因为:
- 早期预警作用
70%的微观缺陷会表现为宏观异常(如颜色变化、纹理异常)
- 全流程覆盖
从裸晶圆到切割封装,需经历超500道工序,每个环节都可能引入新缺陷
- 经济性平衡
相比电子显微镜,光学检测系统能以1/10的成本实现90%的缺陷捕获率
质量守卫:高速机器视觉相机
使用高分辨率和高速机器视觉相机,可设计出适用于宏观缺陷检测的系统,实现晶圆生产的100%检测。同时,该类系统可以一次性采集覆盖晶圆的整个宽度,从而实现高吞吐量。此类宏观缺陷检测系统可带来多种优势:
- 高吞吐量下的100%在线质量控制
- 高成本效益的工艺控制
- 直接反馈给工艺工程师以优化产量
- 可追溯不同生产阶段的每个晶圆
- 投资快速回报
使用此类扫描系统捕获的缺陷类型包括裂纹、划痕、污渍、异物颗粒、未抛光区域、残留物、水印、针孔、剥落、切割后缺陷。
在构建用于晶圆检测的此类宏观缺陷扫描系统时,线阵扫描技术发挥着至关重要的作用。chromasens 线阵扫描相机系列allPIXA evo 和allPIXA wave 提供了TDI (时间延迟积分)选项,分辨率高达16,384像素,非常适合构建此类高性能检测系统。
allPIXA线阵扫描相机系列
chromasens allPIXA相机包含两项专用于晶圆检测系统的突出功能:
① 主从相机同步
② 多通道LED闪光控制/LED频闪

图二:chromasens allPIXA相机
以5-15 μm/像素的分辨率覆盖300mm晶圆的完整视场,需要使用多台线阵扫描相机。这些相机需要完美同步,以实现稳定的图像采集和后续图像分析。chromasens的主从相机同步功能允许完美同步N(1~6)台相机。高度稳定的图像数据采集支持直接图像比较,能够跟踪涂层和蚀刻等多个工艺步骤的稳定性。进行多相机对准时,chromasens GCT软件工具可以协助用户快速,精确,稳定的对齐多相机系统。
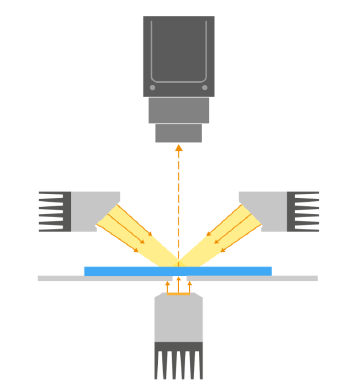
图三:allPIXA相机的多通道频闪功能一次扫描中可最多使用四种几何形状的光源进行成像
chromasens allPIXA 相机的多通道频闪功能(图三)可一次扫描采集多幅图像,每幅图像在不同光源条件下拍摄。而高色彩保真度更有助于在缺陷检测时中获得更出色的结果。
三种不同接口供选:
- 高性价比Camera Link 接口,支持长达15米的allPIXA wave相机的延长电缆。
- CoaxPress 和10 GigE 接口可用于allPIXA evo 相机。
- 4 x CXP 2.0 接口支持更长的电缆长度和最高的速度,而光纤双10GigE接口可支持最长的电缆长度。

图四:chromasens线阵扫描视觉平台可实现多相机和多几何形状光源系统的多功能配置
chromasens作为TKH Vision旗下专注于线扫描的视觉专家,提供完全定制化的视觉检测系统。凭借20多年的行业经验,我们可针对客户的成本、维护、功能和环境要求,提供专属解决方案。从系统设计到图像算法开发,提供全生命周期支持。结合chromasens线阵扫描系统的高精度成像和智能光源控制技术,我们为客户打造完美适配生产需求的检测方案。
来源:Allied Vision工业相机
注:文章版权归原作者所有,本文内容、图片、视频来自网络,仅供交流学习之用,如涉及版权等问题,请您告知,我们将及时处理。



















